电子元器件失效分析
详细介绍:
电子元器件失效分析 ----
失效分析基本概念
1.进行失效分析往往需要进行电测量并采用先进的物理、冶金及化学的分析手段。
2.失效分析的目的是确定失效模式和失效机理,提出纠正措施,防止这种失效模式和失效机理的重复出现。
3.失效模式是指观察到的失效现象、失效形式,如开路、短路、参数漂移、功能失效等。
4.失效机理是指失效的物理化学过程,如疲劳、腐蚀和过应力等。
失效分析的意义
1.失效分析是确定芯片失效机理的必要手段。
2.失效分析为有效的故障诊断提供了必要的信息。
3.失效分析为设计工程师不断改进或者修复芯片的设计,使之与设计规范更加吻合提供必要的反馈信息。
4.失效分析可以评估不同测试向量的有效性,为生产测试提供必要的补充,为验证测试流程优化提供必要的信息基础。
电子器件失效分析的种类:
器件开路失效分析 电迁移失效 EOS失效
器件短路失效分析 腐蚀失效 ESD分析
器件参数漂移分析 潮敏失效分析 机械应力失效
功能失效分析 烧毁失效 各类元器件PFA分析
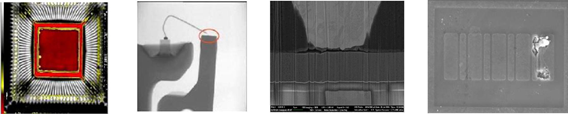
电子元器件检测产品范围:

失效分析流程及设备:

封装级分析:

芯片级分析:

失效分析主要步骤和内容
芯片开封:
去除IC封胶,同时保持芯片功能的完整无损,保持 die,bond pads,bond wires乃至lead-frame不受损伤,为下一步芯片失效分析实验做准备。
SEM 扫描电镜/EDX成分分析:
包括材料结构分析/缺陷观察、元素组成常规微区分析、测量元器件尺寸等等。 探针测试:以微探针快捷方便地获取IC内部电信号。
镭射切割:
以微激光束切断线路或芯片上层特定区域。
EMMI侦测:
EMMI微光显微镜是一种效率极高的失效分错析工具,提供高灵敏度非破坏性的故障定位方式,可侦测和定位非常微弱的发光(可见光及近红外光),由此捕捉各种元件缺陷或异常所产生的漏电流可见光。
OBIRCH应用(镭射光束诱发阻抗值变化测试):
OBIRCH常用于芯片内部高阻抗及低阻抗分析,线路漏电路径分析。利用OBIRCH方法,可以有效地对电路中缺陷定位,如线条中的空洞、通孔下的空洞。通孔底部高阻区等,也能有效的检测短路或漏电,是发光显微技术的有力补充。
LG液晶热点侦测:
利用液晶感测到IC漏电处分子排列重组,在显微镜下呈现出不同于其它区域的斑状影像,找寻在实际分析中困扰设计人员的漏电区域(超过10mA之故障点)。
定点/非定点芯片研磨:
移除植于液晶驱动芯片 Pad上的金凸块, 保持Pad完好无损,以利后续分析或rebonding。
X-Ray 无损侦测:
检测IC封装中的各种缺陷如层剥离、爆裂、空洞以及打线的完整性,PCB制程中可能存在的缺陷如对齐不良或桥接,开路、短路或不正常连接的缺陷,封装中的锡球完整性。
SAM (SAT)超声波探伤:
可对IC封装内部结构进行非破坏性检测, 有效检出因水气或热能所造成的各种破坏如:o晶元面脱层,o锡球、晶元或填胶中的裂缝,o封装材料内部的气孔,o各种孔洞如晶元接合面、锡球、填胶等处的孔洞。
失效分析的一般程序
1、 收集现场场数据

2、电测并确定失效模式
电测失效可分为连接性失效、电参数失效和功能失效。
连接性失效包括开路、短路以及电阻值变化。这类失效容易测试,现场失效多数由静电放电(ESD)和过电应力(EOS)引起。
电参数失效,需进行较复杂的测量,主要表现形式有参数值超出规定范围(超差)和参数不稳定。
确认功能失效,需对元器件输入一个已知的激励信号,测量输出结果。如测得输出状态与预计状态相同,则元器件功能正常,否则为失效,功能测试主要用于集成电路。
三种失效有一定的相关性,即一种失效可能引起其它种类的失效。功能失效和电参数失效的根源时常可归结于连接性失效。在缺乏复杂功能测试设备和测试程序的情况下,有可能用简单的连接性测试和参数测试方法进行电测,结合物理失效分析技术的应用仍然可获得令人满意的失效分析结果。
2、 非破坏检查

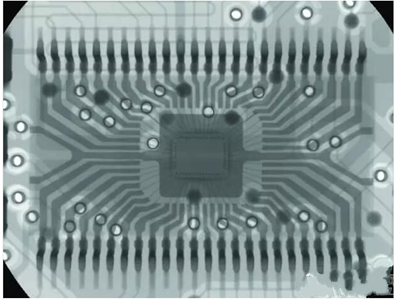
X-Ray检测,即为在不破坏芯片情况下,利用X射线透视元器件(多方向及角度可选),检测元器件的封装情况,如气泡、邦定线异常,晶粒尺寸,支架方向等。

适用情境:检查邦定有无异常、封装有无缺陷、确认晶粒尺寸及layout
优势:工期短,直观易分析
劣势:获得信息有限
局限性:
1、相同批次的器件,不同封装生产线的器件内部形状略微不同;
2、内部线路损伤或缺陷很难检查出来,必须通过功能测试及其他试验获得。
4、打开封装
开封方法有机械方法和化学方法两种,按封装材料来分类,微电子器件的封装种类包括玻璃封装(二极管)、金属壳封装、陶瓷封装、塑料封装等。
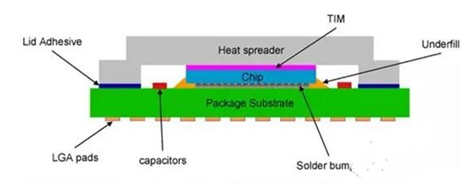
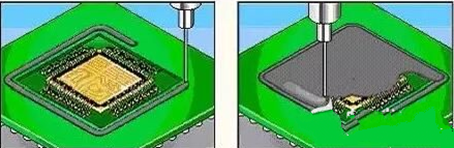
机械开封
化学开封
5、显微形貌像技术
光学显微镜分析技术
扫描电子显微镜的二次电子像技术
电压效应的失效定位技术
6、半导体主要失效机理分析

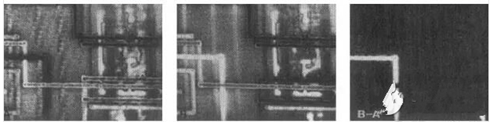
正常芯片电压衬度像 失效芯片电压衬度像 电压衬度差像
电应力(EOD)损伤
静电放电(ESD)损伤
封装失效
引线键合失效:
芯片粘接不良
金属半导体接触退化
钠离子沾污失效
氧化层针孔失效
案例分析:
X-Ray 探伤----气泡、邦定线
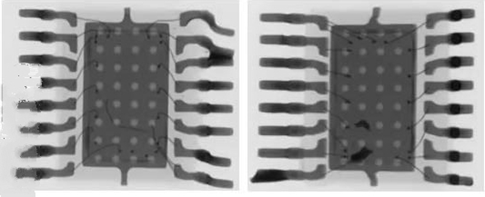
X-Ray 真伪鉴别----空包弹(图中可见,未有晶粒)

“徒有其表” 这个才是货真价实的
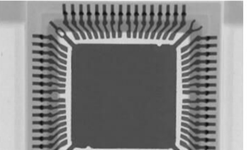
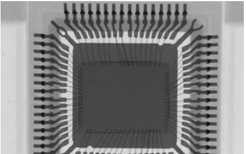
X-Ray用于产地分析(下图中同品牌同型号的芯片) X-Ray 用于失效分析(PCB探伤、分析)


(下面这个密密麻麻的圆点就是BGA的锡珠。下图我们可以看出,这个芯片实际上是BGA二次封装的)
